如何有效提升半導體晶圓厚度量測效率
為何圓盤幾何形狀在晶圓生產中很重要
半導體晶片是從圓柱形矽晶體或矽錠上切割而成的。這些圓盤形晶圓的平整度被控制在嚴格的公差範圍內,以確保整個晶圓表面適合積體電路 (IC) 生產。如果切割後圓盤幾何形狀超出規格,則可以對晶圓進行再處理。然而,切割只是晶圓加工的第一步,後續步驟(如研磨和拋光、薄膜沉積和光刻)會增加成本,如果晶圓無法滿足尺寸規格,將導致大量浪費。本文是系列文章中的第一篇,解釋了為什麼圓盤幾何形狀在晶圓加工的每個步驟中都很重要,以及可能出現的問題。
MTI Instruments 為半導體設計了一系列基於電容的量測系統。在晶圓加工程式的前端,這些系統可以測量圓盤的幾何形狀,從而確保通常價值數千美元的晶圓適合進行其他操作。MTI 的 Proforma 系列產品和 Digital Accumeasure 技術提供快速、易於使用且經濟高效的檢測和測量解決方案。對於半導體行業,使用這些系統的好處包括通過減少浪費和成本來提高盈利能力。
Wafer Cutting晶圓切割
在晶圓切割過程中,矽錠被切成特定厚度。切片的直徑決定了晶圓的直徑(例如300 mm),通常稱為“尺寸”。為避免損壞圓盤併產生廢料(或需要再加工),晶圓切割機需要根據圓盤的厚度和分隔各個模具的“街道”或切割線的寬度,使用正確類型的繩鋸。盡量減少可能導致碎裂或開裂或產生過多灰塵的熱量積聚也很重要。
線鋸的類型很多,包括手動或自動的,支援單線或多線切割,在一個或兩個方向上切割,並安裝在具有不同主軸轉速的不同尺寸的輪毂上。通過適當的刀具選擇和參數優化,晶圓切割機可以確保圓盤的幾何形狀適合其他加工。MTI 的 Proforma 300i 手動計量系統是一種晶圓測厚儀和差分測量系統,為全自動系統提供了一種經濟高效的替代方案。也可以使用 Proforma 300iSA。
Lapping and Polishing研磨和拋光
半導體研磨是一種機械工藝,其中使用帶有研磨液體的焊盤從晶圓襯底上去除多餘的材料。在研磨過程中,將已知厚度的晶圓放置在旋轉研磨臺上。晶圓的正面朝下,朝向研磨表面,該研磨表面會旋轉並去除不需要的材料。去除的材料量因設備類型而異,整個過程需要嚴格控制,以避免去除過多或過少的材料。測量晶圓厚度和總厚度變化 (TTV) 支持正確去除材料的過程控制。
拋光可產生更薄的圓盤,消除次表面損傷,併產生更堅固、更靈活的晶圓。然而,許多拋光方法需要相當多的操作員技能。它們也可能難以複製,因為整個晶圓的磨損需要均勻。如果沒有精確、一致和緊密公差的切割率,檢查可能會發現平面度不足和不合規格的幾何形狀。MTI 的 Proforma 300iSA 半自動測量系統提供全表面掃描,並提供一套強大的測量,包括翹曲和翹曲。與 Proforma 300i 一樣,它的成本也低於全自動晶圓檢測和計量系統。
Thin Film Deposition薄膜沉積
薄膜沉積在晶圓上,以賦予電學、光學和機械特性,從而增強半導體性能;然而,這些塗層需要具有在整個晶圓基底上均勻的特定厚度。點太薄(或太厚)的不規則沉積可能無法滿足性能要求,導致晶圓浪費。無論沉積方法是化學還是物理,在薄膜沉積之前和之後測量晶圓的厚度都很重要。
MTI 基於電容的系統在檢查和測量過程中提供高水準的穩定性、可重複性和準確性。例如,在金屬氧化物薄膜的形成過程中,沉積室內的自耗電容探針可以透過檢測阻抗變化並使用位於同一位置的接地電極來測量介電材料的厚度。借助MTI 的數位精確測量,位於腔室外部的放大器可以將高精度電容電場轉換為高精度 24 位元數位沉積厚度讀數。該技術還可用於透過沉積前和沈積後厚度測量來測量導電薄膜的厚度。
Lithography光刻
半導體光刻透過將複雜的幾何形狀圖案轉移到薄膜上來製造 IC。對於光學光刻或光刻,晶圓表面的變化需要小於曝光工具的焦深。由於先前的晶圓加工步驟(例如研磨、研磨和拋光)會影響晶圓的幾何形狀,因此測量厚度、TTV、翹曲和弓形非常重要。否則,半導體光刻中使用的昂貴製造設備會增加成本,從而導致大量浪費。
光學光刻中的掩模版或光掩模是IC設計的主模板。如果標線與晶圓不共面,可能會導致曝光不良和 IC 有缺陷。傳統上,光刻公司使用電容探針來保持掩模版與晶圓共面;然而,現在改用光學感測器,因為它們可以實現更大的隔離距離。如果隔離不是問題,電容仍然提供快速、經濟高效且相對容易使用的測量技術。 MTI 的電容探頭穩定、精確且具有奈米解析度。
Wafer Inspections and Comparisons 晶圓檢查和技術比較
MTI Instruments 的基於電容的計量和檢測系統使半導體產業能夠檢測晶圓直至光刻工藝,從而避免製造浪費。正如本系列的下一篇文章所解釋的,未能在流程的每個步驟中檢查晶圓可能會帶來巨大的成本。本系列的第三篇也是最後一篇文章比較了全自動、半自動和手動檢測和計量系統,並詳細介紹了 MTI 的 Proforma 300i 和 300iSA 產品。

Proforma 300iSA
半自動晶圓厚度量測儀
Proforma 300iSA 是一款桌上型的半自動晶圓厚度測量系統,,可對厚度、厚度變化、翹曲、翹曲、sori、部位和整體平整度進行完整的晶圓表面掃描。
The Cost of Failing to Inspect Semiconductor Wafers
大多數半導體晶片由矽製成,矽是地殼中第二常見的元素。然而,矽的豐富並不意味著矽片很便宜。半導體中使用的純矽形式不是天然存在的,必須精煉並與改變材料特性和電氣特性的摻雜劑混合。形成矽錠,切割晶片,並在後續加工步驟(包括研磨和拋光、薄膜沉積和光刻)中增加更多成本。本文是系列文章中的第二篇,考慮了與晶圓製造相關的成本,並解釋了為什麼在每個加工步驟中都值得檢查和測量晶圓。
在 MTI Instruments,我們為矽、碳化矽 (SiC)、鍺 (Ge)、磷酸銦 (InP) 和砷化鎵 (GaAS) 製成的半導體晶片製造檢測和計量系統。MTI 的產品包括 Proforma 和 Digital Accumeasure 系統,可對圓盤幾何形狀進行非接觸式測量,這是本系列第一篇文章的主題。由於 MTI 基於電容的系統成本明顯低於全自動設備,因此我們的半自動和手動解決方案可提供更快的投資回報 (ROI)。此外,MTI 的檢測和計量系統可用於加工的前端,而不會因光刻而增加大量成本。到那時,廢物量可能達到數千美元。
The High Cost of Wafer Waste晶圓廢棄物的高成本
對於每個加工步驟,與晶圓相關的成本都會增加。根據 Wafer Pro 的說法,裸盤的價格從 27 美元到 98 美元不等。根據 Wafer World 的說法,每片 100 到 500 美元是典型的,因為優質晶圓的成本明顯高於測試級、虛擬級或回收晶圓。將高性能與高密度相結合的成品半導體晶圓更有價值。據 Tom’s Hardware 網站報導,台積電對 300 nm 5 毫米晶圓的估計價格接近 17,000 美元。部分原因是 TSMC 用於生產這些晶圓的新 N5 技術需要大量的資本支出 (CapEx)。
Tom’s Hardware 的估計遠遠超過了台積電對採用 N7 技術建模的 300 毫米晶圓收取的約 9500 美元的費用。該公司還以約 4,000 美元的價格出售 16 nm 或 12 nm 的 300 mm 晶圓。無論銷售價格如何,這些成品晶圓中的任何一個都比切割和拋光的圓盤產生的成本要高得多。無論是使用現有製造技術的舊設計,還是使用下一代節點製造的新晶圓,半導體行業都可能會因未能在後續加工之前檢查晶圓而增加昂貴的浪費。簡而言之,丟棄 100 美元的裸盤比丟棄 4,000 美元、9,500 美元或 17,000 美元且經過圖案和包裝的成品晶圓要好。
Wafer Sizes, Fabrication Costs, and Rates of Increase晶圓尺寸、製造成本和增長率
由於 CapEx 需要數年時間才能貶值,因此每當引入新的矽片尺寸時,每平方吋矽的成本都會處於最高水準。每平方英寸的成本會隨著時間的推移而降低,但晶圓直徑越大,製造成本也會更高。在 SEMI 的一篇名為《450 毫米晶圓的巨集觀經濟學》的文章中,Apek Mulay 寫道:「晶圓尺寸每連續增加一次,製造成本就會增加大約 1.4 倍。因此,加工世界上最流行的尺寸 300 毫米晶圓的公司已經比 125 毫米或 200 毫米光碟的處理器具有更高的製造成本。
對於各種尺寸的晶圓,隨著時間的推移,半導體行業也可能需要支付更高的製造成本。在安全和新興技術中心 (CSET) 的一份報告中,作者 Saif M. Khan 和 Alexander Mann 寫道,包括半導體製造在內的“最高價值行業”“的成本增長率特別陡峭”。自 2000 年代初以來,晶圓廠成本以每年 10% 以上的速度上漲。CSEET 報告《AI 晶元:它們是什麼以及為什麼重要》還警告說,“隨著半導體複雜性的增加,對高端人才的需求推動了製造成本超支”。固定成本對進入該行業構成了很高的門檻,但可變成本正在擠壓現有參與者的利潤。
用於半導體晶圓檢測和計量的手動、半自動和全自動系統的優勢
可以裝載、掃描和卸載晶圓的全自動系統在大批量下快速、方便且高效。它們可用於檢查每批中的每個晶圓,但這些系統價格昂貴。半自動和手動系統的成本要低得多,通常用於小批量;但是,它們也易於使用,可以進行快速、準確的測量,以支持生產流程。半自動和手動系統還支援批量現場測試或晶圓採樣。
在半導體行業中,每種類型的系統都有應用。例如,製造商可能需要全自動系統來檢查和測量關鍵的高價值中央處理器 (CPU),以檢查每個晶圓。對於不太複雜的微電子或價值較低的積體電路 (IC),製造商可能會決定對具有代表性的晶圓進行採樣更具成本效益。還有一些IC或分立元件,它們的線寬很大,最大焦平面偏差(衡量平坦度的指標)不太重要。對於此類應用,手動或半自動系統可以提供經濟高效的解決方案。
用於非接觸式晶圓檢測的 Proforma 技術
基於電容的手動和半自動非接觸式晶圓檢測和計量系統。這些系統可以通過測量電荷變化與電位(即電壓)的相應變化的比率來評估每分鐘一千個點。使用兩個高解析度非接觸式電容式探針來測量從探針到被測晶圓的距離。一個探針位於頂部,另一個位於晶圓下方,用於測量厚度差異。由於探針的感測元件還提供了一些空間平均,因此這種佈置也適用於切割或未拋光的晶圓。
MTI 專有的推挽™式探針不需要將晶圓接地。探針也只測量到晶圓表面,不受次表面電阻或光學特性(即透明效應,如 SiC 的影響)的影響。 Proforma 系統可以測量最大 300 mm 的晶圓,以及各種圓盤尺寸、厚度和半導體材料類型。Proforma 系列產品包括兩種適用於半導體行業的解決方案。應用包括新材料的鑒定、品質控制 (QC)、質量保證 (QA) 和晶圓採樣。
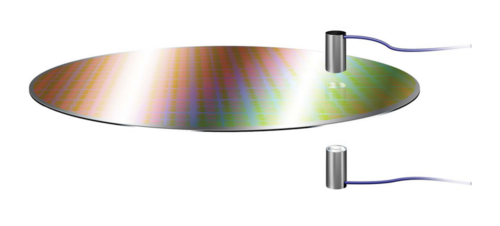
Proforma 300iSA半自動計量系統
MTI 的 Proforma 300iSA 可測量晶圓厚度、TTV 和彎曲度,以及翹曲、位點平整度和整體平整度。它還支援使用參數進行比較,並指示晶圓是否不合格。通過查看晶圓的整個中間表面,而不僅僅是中心點的位置,翹曲提供了對真實晶圓形狀的更有用的測量。平整度測量對於確保晶圓適合平版印刷加工非常重要。否則,有缺陷的IC圖案會因浪費而增加成本。
Proforma 300iSA 的測量範圍為 100 至 1700 μm,精度為 ±0.25 μm。這種半自動系統可與 Proforma 300i 相同的材料一起使用,包括碳化矽 (SiC),這是電動汽車 (EV) 電力電子等應用越來越受歡迎的選擇。Proforma 300iSA 的厚度範圍高達 1700 μm,可以測量以下直徑的晶圓。
- 76 mm
- 100 mm
- 125 mm
- 150 mm
- 200 mm
- 300 mm

由於 MTI 的半自動化系統提供全晶圓表面掃描,因此它使用座標來指示檢測區域。使用者可以關注單一像限或多個像限,包括或排除晶圓的邊緣或中心,還可以檢查定義數量的點。 Proforma 300iSA 每分鐘可以捕獲多達 1000 個點,還可以輸出原始數據,以便與其他軟體進行處理以進行計算和統計分析。
最後,Proforma 300iSA 支援用於晶圓表徵的應力分析。在晶圓加工過程中,機械變化可能會導致晶圓變形,導致晶圓無法使用或不符合規格。 Proforma 300iSA 包含用於分析加工前後晶圓的軟體,以評估其形狀的變化。還包括薄膜應力測量計算演算法。在軟體的分析區域中,使用者需要知道半導體的彈性常數。 通常,此資訊由半導體供應商提供。
